GaN ラッピング&ポリッシング
Trinity-Y
Gallium Nitride(GaN): 研削、ラッピング、CMPマシン
- ワイドギャップ半導体用の次世代材料のプロセスアプリケーションに対する需要の高まりに対応するように設計されています
- マルチフェーズレイアウト。特定のプロセスニーズを満たすシステムを構築するための弾性を提供します
- コンパクトな設計で、ユーザーがプロセスを1つのシステムに統合するための省スペースコンセプトを提供します

高度なウェーハの新しい設計と技術統合
Trinity-Y First
- 垂直研削盤
- ラッピング&フェーシングマシン
- CMPマシン
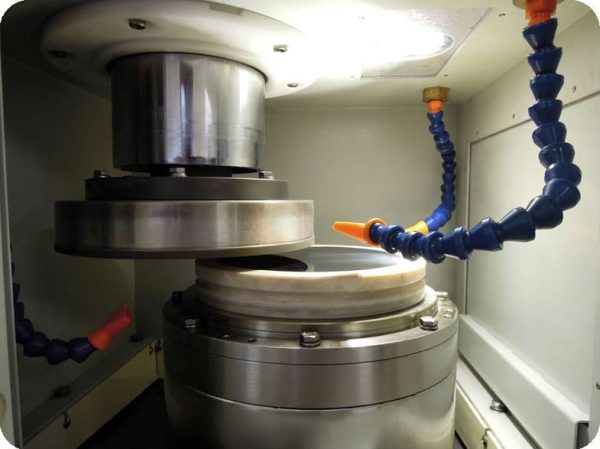
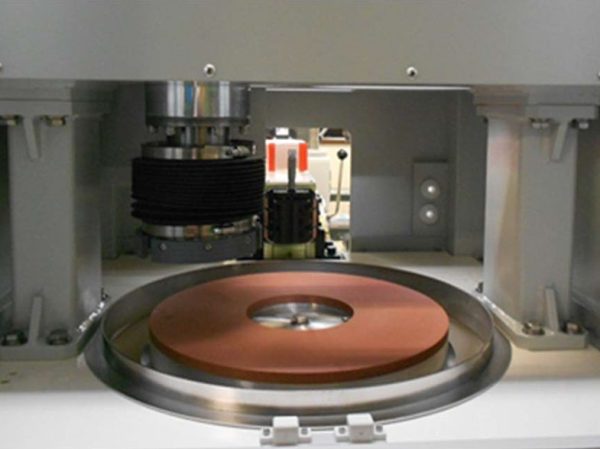
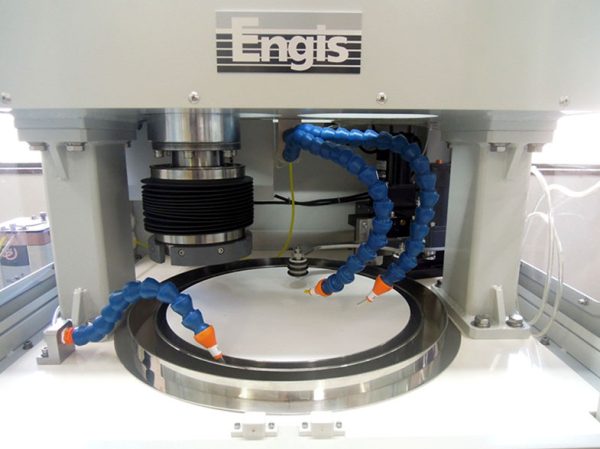
Trinity-Y EVG-200
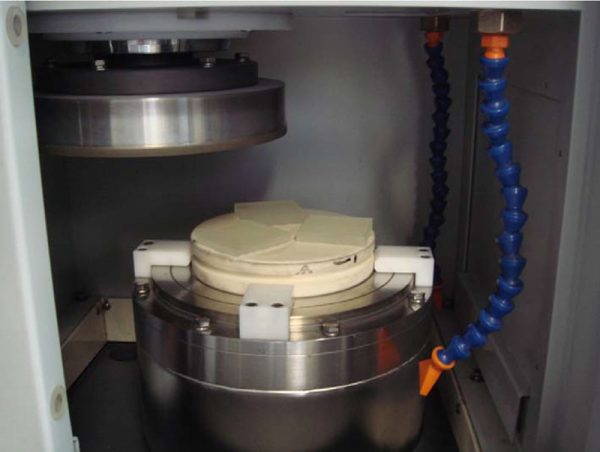



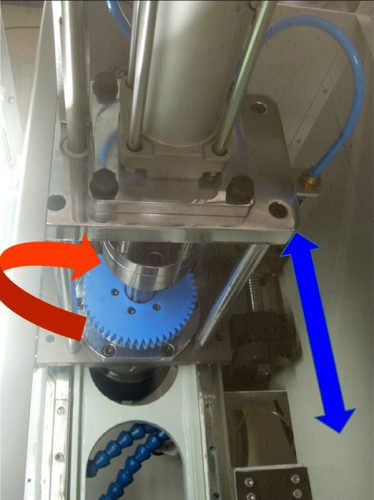
片面研磨システム
EJ-380IY
Lapping and CMP Machine

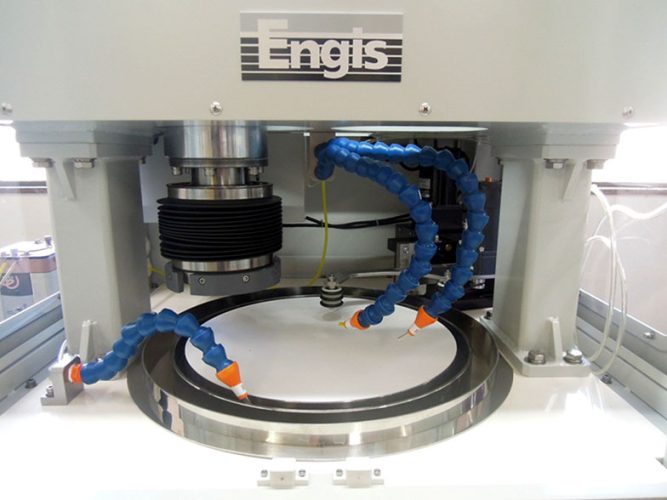
両面研磨システム EJD-6B
この上部と下部のラッピングプレートは、それぞれ反対方向に回転します。 上下のラッピングプレートの間に挿入されたキャリアは、回転しながら下のラッピングプレートと同じ方向に回転します。 キャリア内のオブジェクトには、4つの方向への移動が与えられます。
また、上下のラッピングプレートとキャリアの回転比を調整し、両面を同時に均等にラッピングすることで、短時間で非常に高いラッピング精度を実現しています。
他のTrinity-Y機器と組み合わせると、スペースを節約し、高効率の処理システムを構築できます。




EJD-6BY 仕様
| プレート | OD 386mm x ID 148mm |
|---|---|
| 回転数 | Max. 10~60 r.p.m. |
| メインモーター | 2.2kw 200V 3相 |
| 運転システム | 4ウェイ 5ワーク ホールディング キャリア |
| アッパープレートコントロール | 空気圧 シリンダー Φ125*400mm |
| 操作パネル | 7.4” カラー LCD タッチ パネル |
| 制御システム | PLC (Mitsubishi) |
| プログラム | ( マルチステップ プログラム ) 5ステップ |
| レシピ数 | 10 レシピ |
| 圧力制御 | 逆圧バランス制御 |
| 施設の要件 | 電源 : 200v 3相 30A エア : CDA 0.5Mpa |
| 寸法 | 800 x 800 x 1920 (mm) |
オプション
- 様々なラッピングスラリー
- 研磨パッド
- パッドドレッサー
- パッドコンディショニングブラシキャリア
- CMPスラリータンク
- スラリー冷却ユニット(チラー)
- 研削プレート

先端材料産業セグメント

Gallium Nitrideウェーハ 2 インチ

| 素材 | 最大2インチ |
|---|---|
| 厚さ | 0.25~0.6mm |
| 基板の向き | (0001) |
| 伝導タイプ | n-type |
| キャリア濃度 (cm-2) | typical 5 x1018 |
| キャリア移動度 (cm2/Vsec) | typical 170 |
| 抵抗率 (Ω/cm) | 8 x 10-3 |
GaNラッピングプロセス
| 条件 | ステップ 1 | ステップ 2 | ステップ 3 |
|---|---|---|---|
| 装置 | Trinity-Y EVG200TY | Trinity-Y EJW-380IF-TY | Trinity-Y EJW-380CMP-TY |
| ラッププレート | MAD #8000 Wheel | Almet825 | ForGaN PAD |
| プレート速度 | 1000 rpm/100 rpm | 60 rpm | 60 rpm |
| プレート条件 | ドレッシングブロック | フェーシング | ACR |
| フィクスチャ | セラミックプレート φ138 Waxing | セラミックプレート φ138 Waxing | セラミックプレート φ138 Waxing |
| コンディションリング | --- | --- | --- |
| スラリー | Coolant 81E | 1/2um-STD-LEDW | SP |
| スラリー供給 | サーキュレーション | 滴下 | 滴下 |
| 重さ | --- | 20kg/3pcs | 15kg/3pcs |
| ラップタイム | 1st0.5u/min 2nd 0.3u/min | 30min | 6hr |
研削した後の表面

ラッピングした後の表面

CMPした後の表面