GaN 研磨拋光
Trinity-Y
GaN 研磨.精磨.CMP機台
- 三機一體式,多功能精磨系統
- 為滿足下一代材料「寬能隙半導體」製程應用而設計
- 多工序、精簡設計,節省空間, 可彈性調整滿足客戶特定製程需求,整合成一套系統

先進晶圓用之新設計與技術整合
Trinity-Y First
- 立式減薄磨床
- 平面研磨
- CMP拋光機
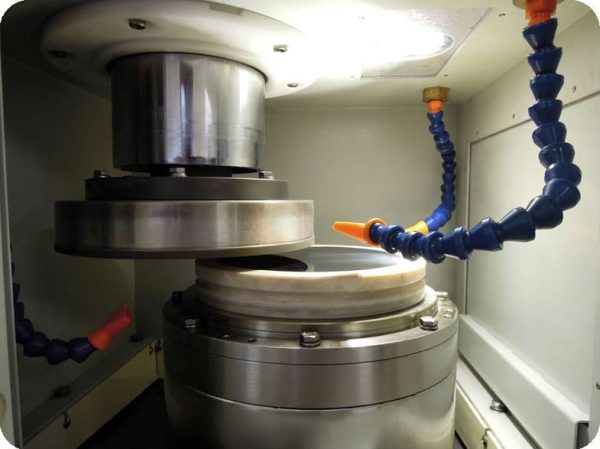
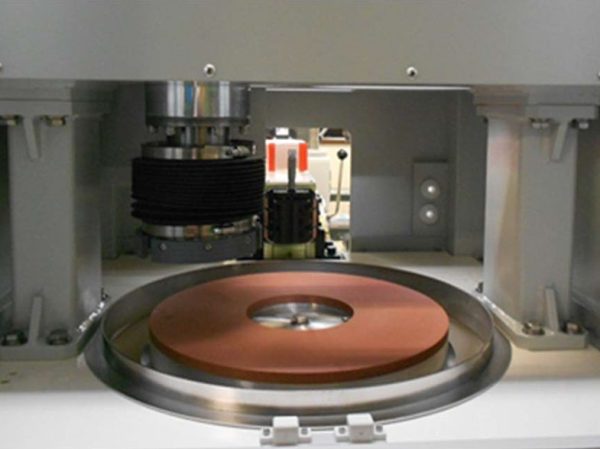
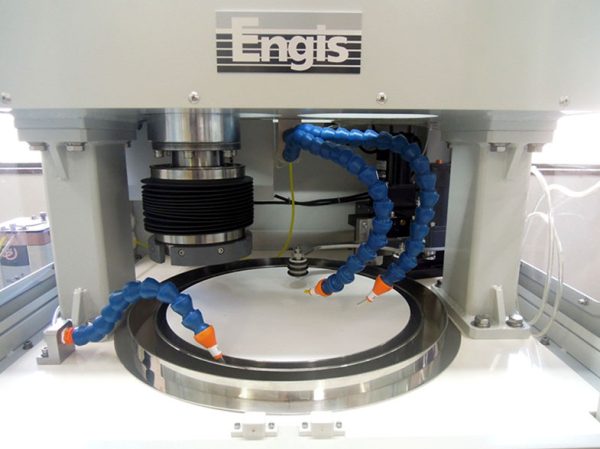
Trinity-Y EVG-200
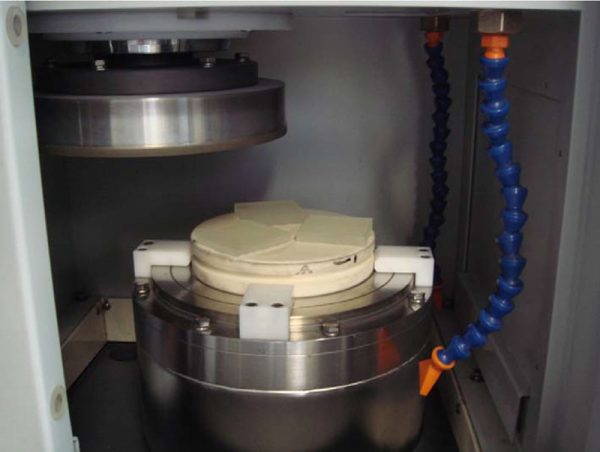



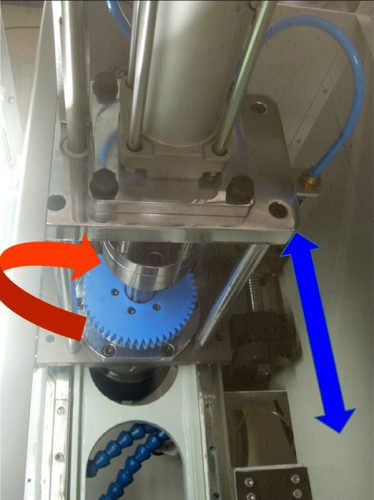
單面拋光系統
EJ-380IY
Lapping and CMP Machine

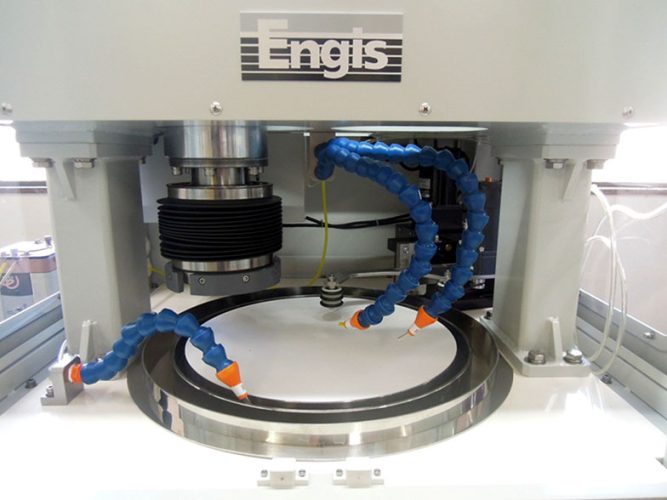
多功能雙面拋光系統 EJD-6B
上下磨盤分別以相反方向旋轉,中間的載子和下磨盤同向旋轉;載體中的物體進行四個方向的運動。
上下磨盤和載體的旋轉比率經巧妙設計,以達同時對兩表面進行相等的研磨,可在很短的製程時間內達到非常高的研磨精度!
與Trinity-Y組合,可節省空間,又能建立高效加工系統。




EJD-6BY Specifications
| 磨盤 | OD 386mm x ID 148mm |
|---|---|
| 轉速 | Max. 10~60 r.p.m. |
| 主馬達 | 2.2kw 200V 3相 |
| 驅動系統 | 4 路 5工件游星輪 |
| 上磨盤控制 | 氣缸 Φ125*400mm |
| 操作面板 | 7.4” 彩色 LCD 觸控面板 |
| 控制系統 | PLC (三菱) |
| 程序 | (多步程序) 5步程序 |
| 配方數 | 10 |
| 壓力控制 | 反壓平衡控制 |
| 設備要求 | 電源:200v 3相 30A 空氣:CDA 0.5Mpa |
| 尺寸 | 800 x 800 x 1920 (mm) |
選配
- 各式鑽石液
- 拋光墊
- 拋光墊修整器(Pad Dresser)
- 拋光墊修整刷架
- CMP液體供應系統
- 冷卻裝置
- 研磨盤

先進材料處理

Gallium Nitride Wafer 2 inch

| 基材 | 2 inch maximum |
|---|---|
| 厚度 | 0.25~0.6mm |
| 基材方向 | (0001) |
| 傳導方式 | n-type |
| 載子濃度 (cm-2) | typical 5 x1018 |
| 載子移動率 (cm2/Vsec) | typical 170 |
| 電阻率 (Ω/cm) | 8 x 10-3 |
GaN 精磨製程
| Conditions | Step 1 | Step 2 | Step 3 |
|---|---|---|---|
| 機台 | Trinity-Y EVG200TY | Trinity-Y EJW-380IF-TY | Trinity-Y EJW-380CMP-TY |
| 磨盤 | MAD #8000 Wheel | Almet825 | ForGaN PAD |
| 磨盤速度 | 1000 rpm/100 rpm | 60 rpm | 60 rpm |
| 盤面修整方式 | 修整塊 | Facing | ACR |
| 治具 | 陶瓷盤φ138 Waxing | 陶瓷盤φ138 Waxing | 陶瓷盤φ138 Waxing |
| 修正環 | --- | --- | --- |
| 鑽石液 | Coolant 81E | 1/2um-STD-LEDW | SP |
| 鑽石液供應方式 | 循環 | 滴下 | 滴下 |
| 重量 | --- | 20kg/3pcs | 15kg/3pcs |
| 精磨時間 | 1st0.5u/min 2nd 0.3u/min | 30min | 6hr |
研磨後表面數據

精磨後表面數據

CMP後表面數據